熱載流子晶體管是一類利用載流子過剩動能的器件��。與依賴穩(wěn)態(tài)載流子傳輸?shù)钠胀ňw管不同�����,熱載流子晶體管將載流子調(diào)制到高能態(tài)�,從而提高器件的速度和功能。這些特性對于需要快速切換和高頻操作的應用至關(guān)重要��,例如先進的電信和尖端計算技術(shù)�����。然而��,傳統(tǒng)的熱載流子產(chǎn)生機制是載流子注入或加速�����,這限制了器件在功耗和負微分電阻方面的性能��?�;旌暇S器件結(jié)合了塊體材料和低維材料�,可以通過利用能帶組合形成的不同勢壘為熱載流子產(chǎn)生提供不同的機制。
鑒于此�,中國科學院金屬研究所研究員成會明院士、劉馳���、孫東明聯(lián)合北京大學助理教授張立寧報告了一種基于雙混合維石墨烯/鍺肖特基結(jié)的熱發(fā)射晶體管����,該晶體管利用受激載流子的受激輻射實現(xiàn)亞閾值擺幅低于玻爾茲曼極限每十年1毫伏����,并在室溫下實現(xiàn)峰谷電流比大于100的負微分電阻。進一步展示了具有高反相增益和可重構(gòu)邏輯狀態(tài)的多值邏輯��。這項工作報告了一種多功能熱發(fā)射晶體管����,在低功耗和負微分電阻應用方面具有巨大潛力,標志著后摩爾時代的一項有希望的進步���。相關(guān)研究成果以題為“A hot-emitter transistor based on stimulated emission of heated carriers”發(fā)表在最新一期《Nature》上��。
裝置結(jié)構(gòu)及特點
作者報告了一種基于雙石墨烯/鍺肖特基結(jié)的混合維熱發(fā)射極晶體管(HOET)����。晶體管本質(zhì)上是由一個帶有缺口的單層石墨烯(Gr)和一個p型Ge襯底組成。Gr通過二氧化鉿(HfO2)窗口與Ge接觸�。兩個分離的Gr層用作發(fā)射極(emitter-Gr)和基極(base-Gr),Ge襯底用作集電極(圖1a�、b)。器件采用Gr轉(zhuǎn)移和標準半導體工藝制造����。Gr中的缺口是使用光刻技術(shù)制造的,缺口長度為2μm至75μm(圖1c)���。對于晶體管�,傳輸特性(Ic-Vb)中集電極電流Ic和基極電壓Vb的關(guān)系顯示出超出玻爾茲曼極限的突然電流變化���,其中亞閾值擺幅(SS)低于1 mV dec?1(圖1d),而輸出特性(Ic-Vc)中的Ic和集電極電壓Vc的關(guān)系顯示NDR的峰谷電流比(PVR)約為100(圖1e)���。
圖1 裝置結(jié)構(gòu)及基本特性
超低亞閾值擺幅
SS是表征晶體管開關(guān)性能的基本參數(shù)���。HOET工作時��,發(fā)射極偏置Ve接地�,使晶體管具有共發(fā)射極配置��。當基極偏置Vb增加時�,在臨界基極偏置Vb-critical下,觀察到負集電極電流Ic�����,電流變化相當突然(圖1d和2a)�。在室溫下,隨著Vc的增加�����,電流突變超出了玻爾茲曼極限�����,其中最小SS在0.38–1.52?mV?dec?1范圍內(nèi)��,SS小于60?mV?dec?1的電流范圍約為1至3個數(shù)量級���,并且可能進一步增加(圖2b)�����。對于SS小于60?mV?dec?1的電流���,平均SS為0.82?mV?dec?1至6.1?mV?dec?1��,最大導通電流為73.9?μA?μm?1至165.2?μA?μm?1���,這是報告的最佳結(jié)果之一(圖2c)。
熱載流子受激發(fā)射機制
由于Gr是p型���,因此空穴是HOET中的主要導電載流子���,突變的負Ic表示流出集電極的空穴電流突然增加,這既不是Gr/Ge結(jié)的正常反向漏電流����,也不是基極-Gr/p-Ge結(jié)的正向電流。四種現(xiàn)象揭示了器件的工作機制�。首先��,傳輸特性依賴于溫度(圖2d)���。其次�����,Ic突變時的臨界基極偏置Vb-critical隨Vc線性增加����,Vc???Vb-critical約為0.7?V,導致基極-Gr/p-Ge結(jié)正向偏置(圖2e)��。第三����,在Vc的每個偏置下,Vb-critical會隨著間隙長度dgap的增加而增加(以5μm為步長從5μm增加到75μm;圖2f)��。最后�,Ic和Ie同時急劇增加(圖2g)。這些現(xiàn)象可以總結(jié)為����,最初發(fā)射極-Gr/p-Ge結(jié)和基極-Gr/p-Ge結(jié)都處于反向偏置,當基極偏置增加到臨界值時�,基極-Gr/p-Ge結(jié)充分正向偏置,因此發(fā)射極-Gr中大量的空穴會突然發(fā)射到Ge集電極中����,而空穴會從發(fā)射極進入���,以確保從發(fā)射極到集電極的連續(xù)電流。溫度越高�����,這種現(xiàn)象越明顯�����,間隙越短���,臨界基極偏置越小��。
最后��,作者提出了一種熱載流子受激發(fā)射(SEHC)機制��,使用器件的結(jié)構(gòu)圖(圖2h)和能帶圖(圖2i)來解釋這些現(xiàn)象��。
圖2 超低 SS 和 SEHC 機制
負微分電阻
在HOET中���,輸出特性Ic–Vc表現(xiàn)出明顯的NDR(圖1e和3a)。當集電極偏壓Vc增加時�,Ic首先增加到峰值,然后減小到Gr/Ge結(jié)的反向電流�。輸出特性與溫度有關(guān),當溫度降低時����,NDR逐漸消失(圖3b),并且在每個Vb偏壓下���,Ic達到最大值的電壓Vc-peak隨著間隙長度dgap的增加而減小(圖3c)�。峰谷電流隨基極偏置Vb增大而增大(圖3d)�����,PVR從90.6增大到24.6(圖3d)��。當Vb為-3V時���,較高的PVR是由于Gr/Ge結(jié)的漏電流較小�,最佳PVR為126����。這個結(jié)果是使用Gr的器件中最高的值之一�����,高于任何使用Si和Ge技術(shù)的RSTT(圖3e)����,也與使用二維材料的隧道器件的最佳結(jié)果相當�����。
這些現(xiàn)象符合SEHC機制:在輸出特性中����,對于每一個負偏壓Vb,隨著負偏壓Vc的增加��,發(fā)射極-Gr處的熱空穴被集電極收集�����,產(chǎn)生很大的負Ic���,逐漸達到峰值電流;當Vc進一步增加時�����,基極-Gr/Ge結(jié)的偏壓由正向偏壓變?yōu)榉聪蚱珘?����,載流子注入過程停止���,產(chǎn)生谷值電流。
圖3 負微分電阻
多值邏輯技術(shù)
多功能HOET在各種應用中都有著廣闊的前景���。作者使用三個HOET(T1-T3)與共發(fā)射極��、共集電極(Ge襯底)和獨立基極1-3并聯(lián)來制作電路���,由等效電路和器件符號說明(圖4a、b)�。為了演示高反相器增益,作者使用一個基極電壓作為輸入信號(IN��,以Vb3為例)���,并且集電極電流Ic為輸出信號(OUT;圖4c)�����。首先�����,當Ic突變導致邏輯狀態(tài)改變時��,反相器增益gm(跨導dIc/dVb3)較高�,接近1?mA?μm?1?V?1,可用于制作低功耗MVL(圖4d)����。其次,可以并聯(lián)更多HOET���,使用簡單結(jié)構(gòu)實現(xiàn)五進制甚至更高進制的系統(tǒng)�。第三��,Ie對Vb3的依賴性也是四進制反相器的行為����,這為電路設計提供了更大的靈活性(圖4e、f)�。
為了演示可重新配置的邏輯狀態(tài)����,作者研究了輸出特性Ic–Vc���。當輸入邏輯信號為(2,1,0)時��,若輸出邏輯信號為(0,1,2)���,則該電路為三值數(shù)字邏輯反相器(圖4g)����。如果輸出邏輯信號為(2,1,0),則為三進制跟隨器(圖4h)����。如果輸出邏輯信號為(0,2,1),則可以用來構(gòu)造加法器(圖4i)���。通過使用不同的基極偏置可以實現(xiàn)更多的可能性��,并且可以并聯(lián)更多的HOET以實現(xiàn)更高的系統(tǒng)���。
圖4 MVL技術(shù)的HOET
總 結(jié)
HOET采用基于混合維度材料的SEHC機制��,為熱載流子晶體管家族提供了又一個成員���,其產(chǎn)生的超低SS是報道值中最低的之一,而NDR效應中的PVR是Gr器件中最高的之一���。通過結(jié)合正確的材料和器件結(jié)構(gòu)�,HOET可以提供多功能高性能器件�����,在后摩爾時代的低功耗和NDR技術(shù)中具有潛在應用�。

 770
770
 0
0 
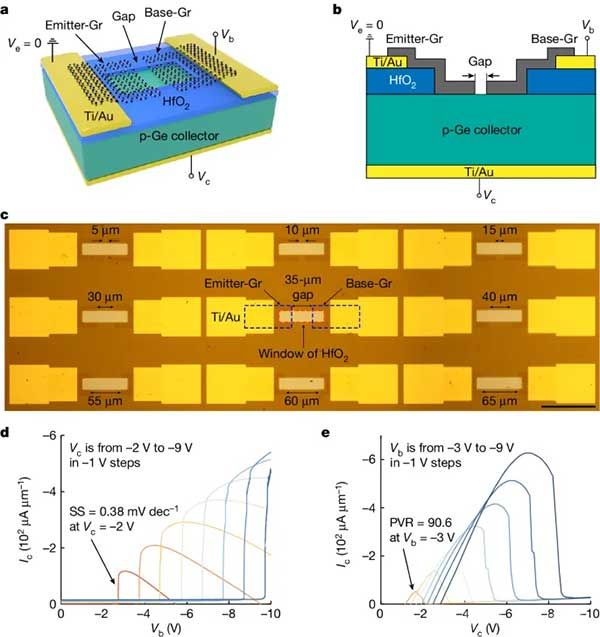



 分享 0
分享 0
 舉報 0
舉報 0
 收藏 0
收藏 0
 反對 0
反對 0
 點贊 0
點贊 0

 中冶有色技術(shù)平臺
中冶有色技術(shù)平臺
